





















病例摘要
845SOM PCBA
突發性功能喪失,表現為設備無法開機
同一批次4個樣本(含點膠與未點膠兩種工藝)先后出現相同故障
常規外觀檢查、X-RAY透視均未發現異常
啟動自檢數據顯示信號傳輸中斷,發熱后可暫時緩解
近期,某智能終端產品在客戶端反饋:多片PCBA出現不開機故障,涉及點膠與未點膠兩種工藝狀態。失效現象一致:上電后無法正常啟動,嚴重影響產品交付與客戶體驗。
面對這樣的失效,如何快速定位問題?是焊接問題?芯片本身?還是PCB板?我們通過一系列失效分析手段,逐步揭開真相...
? 外觀檢查:無明顯異常
4片樣品中,1#、2#為點膠失效,3#、4#為未點膠失效。初步外觀觀察,除3#、4#有導線引出外,未見明顯物理損傷或異常。
? X-RAY測試:內部結構未見異常
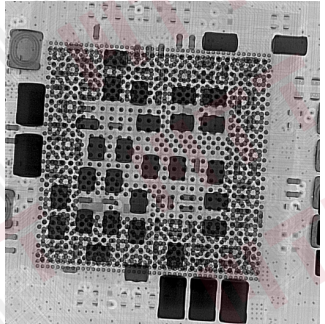
失效樣品POP芯片X-RAY圖

失效樣品PM芯片X-RAY圖
對POP封裝芯片及PM芯片進行X-RAY透視檢查,未發現焊接短路、空洞、橋接等明顯異常,初步排除典型焊接缺陷。
?? 啟動自檢分析:故障指向芯片周邊電路
通過串口輸出數據分析:

1#樣品首次通電串口輸出數據顯示“ERROR: Out of Bound Temp Conditon Occured, Performing AFP: VBATT TEMP : -30 DegC.; Min Limit: -20; Max Limit: 80;”,說明電源管理芯片有異常

1#樣品通電一段時間后重啟,串口的數據,PON寄存器數值與正常的不一致

2#首次通電串口輸出數據與1#樣品一致

2#樣品重啟后串口輸出數據,顯示UFS錯誤

2#樣品重啟后串口輸出數據追查,判斷可能是flash存儲器出錯

3#樣品輸出數據,顯示PM與DDR可能有問題,DDR在開始初始化后輸出數據就停止輸出
1#、2#樣品首次通電報“電池溫度超出范圍”,提示可能為CPU或電源管理芯片引腳懸空;
3#樣品PM與DDR初始化中斷;
4#樣品無任何輸出。
結果顯示,故障可能與信號傳輸中斷有關,且發熱可暫時緩解部分異常,提示接觸不良類問題。
?? 切片分析:發現問題端倪
對POP芯片進行在板切片:

1#樣品切片第1排,發現POP芯片填充膠未填充完全
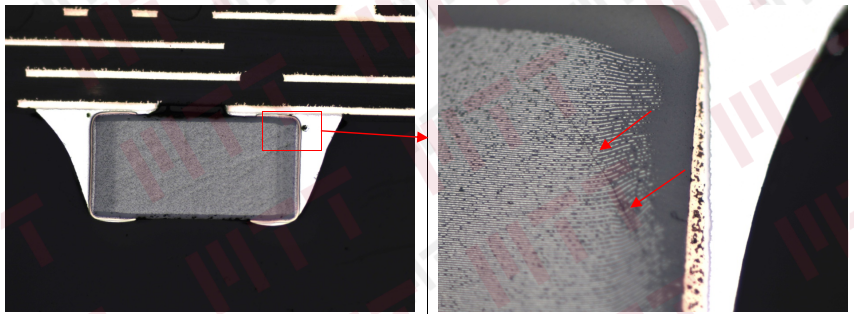
3#失效樣品的POP做切片測試,發現POP背面的PCB上的一個電容有裂紋
1#樣品填充膠未完全填充;
3#樣品POP背面電容存在裂紋;
所有樣品均在POP芯片下方的PCB埋孔位置發現裂紋或界面異常。
?? SEM測試:裂紋與空洞清晰可見
進一步通過掃描電鏡觀察:
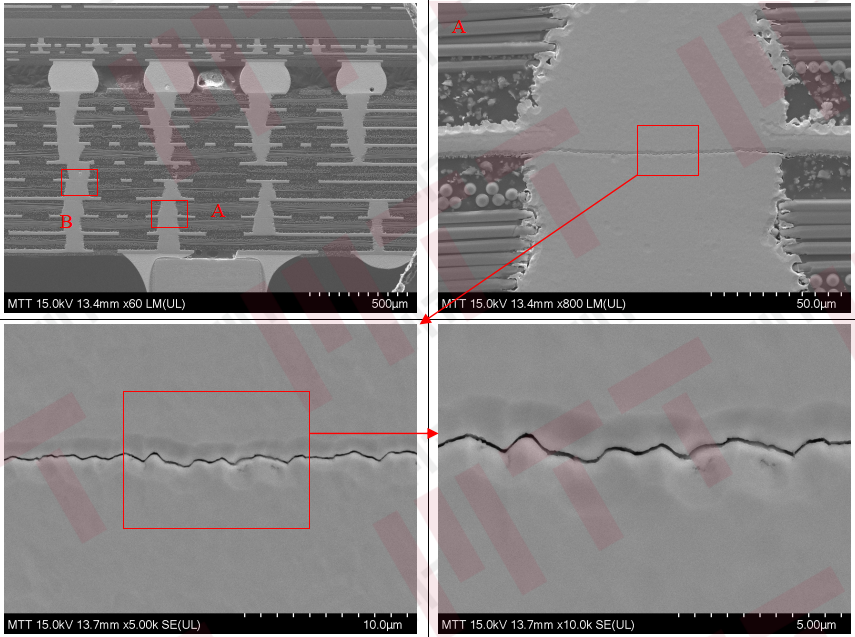
1#樣品切片的第8排切片截面埋孔裂紋SEM照片
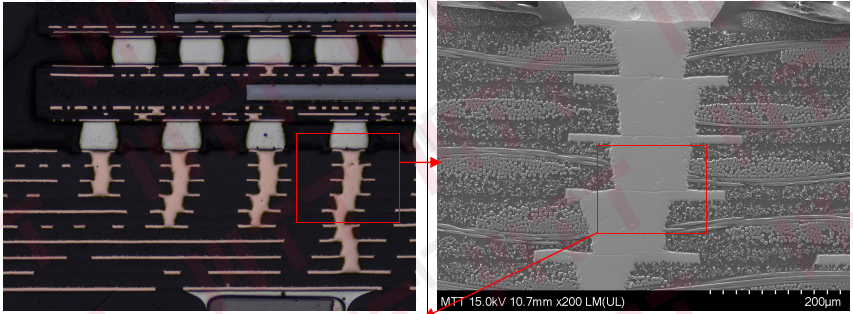
2#樣品切片的第6排切片截面埋孔裂紋SEM照片
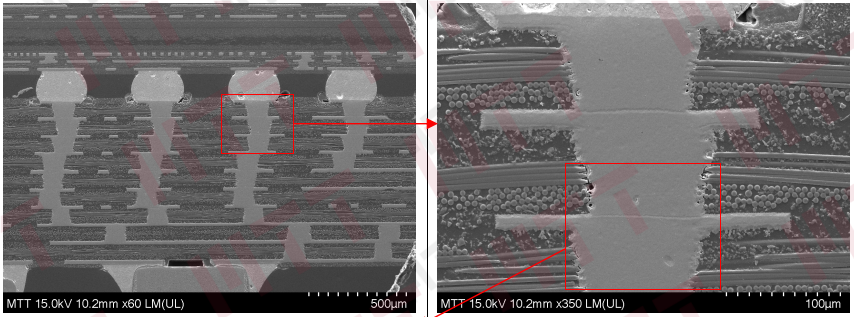
4#樣品切片的第5排切片截面埋孔裂紋SEM照片
1#、4#樣品埋孔有明顯裂紋;
2#樣品埋孔界面存在明顯空洞。
這些異常結構會導致信號路徑阻抗變化,影響信號完整性,最終引發不開機故障。
結論
PCBA失效的主要原因為POP芯片底部PCB埋孔存在開裂及界面空洞異常,導致埋孔阻抗增大,信號傳輸異常。個別樣品中電容裂紋也為次生因素。
建議
PCB來料可靠性評估: 加強對PCB的熱應力測試,特別是埋孔結構的可靠性驗證,防止異常物料流入產線;
工藝過程應力控制: 對回流焊、點膠等工序進行應力應變測試,優化工藝參數,減少對PCB和元件的機械熱應力影響。
你有沒有遇到過PCBA因PCB內部結構問題導致的失效?





